商机详情 -
附近烧结金胶要求
2013 年 12 月起,田中贵金属工业开始提供使用次微米级金粒子膏材 "AuRoFUSE™",通过高精密网版印刷法在基板上一次印刷即可形成微细复合图案的技术。这一技术使得复杂的 MEMS 结构能够通过简单的印刷工艺实现,很好降低了制造成本和工艺复杂度。在MEMS 代工制造领域,AuRoFUSE™技术也发挥着重要作用。田中贵金属工业与 MEMS CORE 公司签订共同研发协议,针对次微米大小金粒子 MEMS 装置的图案形成技术展开技术合作,建立了从 MEMS 零件的试作到安装的代工制造厂能力。这种合作模式为 MEMS 厂商提供了从材料研发到设备组装的一站式解决方案。创新的烧结金胶,应用于光通信器件,无卤素配方。附近烧结金胶要求

传统的面朝下接合结构必须使用价格高昂的氮化铝基板,而采用AuRoFUSE™技术后,能够直接与金属基板接合,成本不仅较为低廉,还能制造出更小型且高性能的模组。这一成本优势使得高功率LED技术能够在更广泛的应用领域得到推广。在特殊环境LED照明应用中,AuRoFUSE™技术展现出了优异的适应性。开发出的LED模组可适应过度的温度高低变化,因此可用于预计今后进出口时需求渐增的冷冻仓库用照明。此外,小型模组还可应用于车用照明的制造,以提升车辆的设计性等,甚至能够解决过去成本高昂、开发困难的各种问题。天附近烧结金胶要求烧结金胶独特的,在功率器件中使用,操作简便。
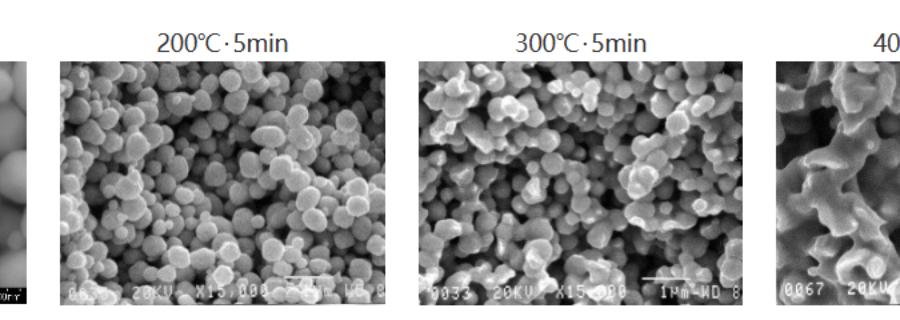
2013年12月起,田中贵金属工业开始提供使用次微米级金粒子膏材"AuRoFUSE™",通过高精密网版印刷法在基板上一次印刷即可形成微细复合图案的技术。这一技术使得复杂的MEMS结构能够通过简单的印刷工艺实现,很好降低了制造成本和工艺复杂度。在MEMS代工制造领域,AuRoFUSE™技术也发挥着重要作用。田中贵金属工业与MEMSCORE公司签订共同研发协议,针对次微米大小金粒子MEMS装置的图案形成技术展开技术合作,建立了从MEMS零件的试作到安装的代工制造厂能力。这种合作模式为MEMS厂商提供了从材料研发到设备组装的一站式解决方案。765
如果使用金 - 锡类焊料接合,材料将会熔融,但使用 "AuRoFUSE™" 接合,即使在 300℃高温下也能保持稳定的接合性能。这一高温稳定性特性使得 AuRoFUSE™成为 SiC 和 GaN 功率器件封装的理想选择。随着新能源汽车、5G 基站、工业自动化等领域对高效率功率器件需求的快速增长,能够在高温下稳定工作的封装材料变得越来越重要。产品在传统功率器件应用中也表现出色。田中贵金属提供的产品组合中包括应对用于功率器件的 Si、下一代半导体 SiC、GaN 的固晶用导电胶。这种大方面的产品布局使得客户能够在不同技术路线的功率器件中都能找到合适的封装解决方案。先进的烧结金胶,应用于 LED 封装,具备高纯度金。

TANAKA 烧结金胶在工艺技术层面展现出了重要的创新优势,这些优势直接转化为客户在生产效率和成本控制方面的实际收益。产品的工艺兼容性极强,可以在大气或气体环境中进行键合,键合后无需清洗。这一特性大幅简化了工艺流程,降低了生产成本。在热压工艺方面,产品表现出了优异的可控性。以 AuRoFUSE™预制件为例,在 200℃、20MPa、10 秒的热压条件下,虽然在压缩方向上显示出约 10% 的收缩率,但在水平方向上较少变形,可用作接合强度足以承受实际应用的 Au 凸块。这种可控的变形特性确保了键合的精度和可靠性。
低温的烧结金胶,含亚微米金粒子,降低能耗。附近烧结金胶要求
烧结金胶先进的,用于 MEMS 气密封装,优化光学性能。附近烧结金胶要求
在第三代半导体器件应用中,AuRoFUSE™技术具有不可替代的优势。使用碳化硅(SiC)、氮化镓(GaN)的次世代功率半导体,操作温度有超过300℃的情形。如果使用金-锡类焊料接合,材料将会熔融,但使用"AuRoFUSE™"接合,即使在300℃高温下也能保持稳定的接合性能。这一高温稳定性特性使得AuRoFUSE™成为SiC和GaN功率器件封装的理想选择。随着新能源汽车、5G基站、工业自动化等领域对高效率功率器件需求的快速增长,能够在高温下稳定工作的封装材料变得越来越重要。。。附近烧结金胶要求