商机详情 -
折射率膜厚仪国内代理
显微镜转接器F40系列转接器。Adapter-BX-Cmount该转接器将F40接到OlympusBX或MX上而不必使用Olympus价格较贵的c-mount转接器。MA-Cmount-F20KIT该转接器将F20连接到显微镜上(模仿F40,光敏度低5倍),包括集成摄像机、光纤、TS-Focus-SiO2-4-10000厚度标准、F40软件,和F40手册。软件升级:UPG-RT-to-Thickness升级的厚度求解软件,需要UPG-Spec-to-RT。UPG-Thickness-to-n&k升级的折射率求解软件,需要UPG-RT-to-Thickness。UPG-F10-AR-HC为F10-AR升级的FFT硬涂层厚度测量软件。包括TS-Hardcoat-4um厚度标准。厚度测量范围0.25um-15um。UPG-RT-to-Color&Regions升级的色彩与光谱区域分析软件,需要UPG-Spec-to-RT 。可选粗糙度: 20 — 1000Å (RMS)。折射率膜厚仪国内代理

F60系列包含的内容:集成平台/光谱仪/光源装置(不含平台)4",6"and200mm参考晶圆TS-SiO2-4-7200厚度标准真空泵备用灯型号厚度范围*波长范围F60-t:20nm-70µm380-1050nmF60-t-UV:5nm-40µm190-1100nmF60-t-NIR:100nm-250µm950-1700nmF60-t-EXR:20nm-250µm380-1700nmF60-t-UVX:5nm-250µm190-1700nmF60-t-XT0:2µm-450µm1440-1690nmF60-t-s980:4µm-1mm960-1000nmF60-t-s1310:7µm-2mm1280-1340nmF60-t-s1550:10µm-3mm1520-1580nm额外的好处:每台系统內建超过130种材料库,随着不同应用更超过数百种应用工程师可立刻提供帮助(周一-周五)网上的“手把手”支持(需要连接互联网)硬件升级计划折射率膜厚仪国内代理膜厚仪是一种用于测量薄膜或涂层的厚度的仪器.

Filmetrics 的技术Filmetrics 提供了范围广范的测量生物医疗涂层的方案:支架: 支架上很小的涂层区域通常需要显微镜类的仪器。 我们的 F40 在几十个实验室内得到使用,测量钝化和/或药 物输送涂层。我们有独特的测量系统对整個支架表面的自動厚度测绘,只需在测量时旋轉支架。植入件: 在测量植入器件的涂层时,不规则的表面形状通常是为一挑战。 Filmetrics 提供这一用途的全系列探头。导丝和导引针: 和支架一样,这些器械常常可以用象 F40 这样的显微镜仪器。导液管和血管成型球囊的厚度:大于 100 微米的厚度和可见光谱不透明性决定了 F20-NIR 是这一用途方面全世界众多实验室内很受欢迎的仪器。
厚度测量产品:我们的膜厚测量产品可适用于各种应用。我们大部分的产品皆備有库存以便快速交货。请浏览本公司网页产品资讯或联系我们的应用工程师针对您的厚度测量需求提供立即协助。单点厚度测量:一键搞定的薄膜厚度和折射率台式测量系统。测量1nm到13mm的单层薄膜或多层薄膜堆。大多数产品都有库存而且可立即出货。F20全世界销量蕞hao的薄膜测量系统。有各种不同附件和波长覆盖范围。微米(显微)级别光斑尺寸厚度测量当测量斑点只有1微米(µm)时,需要用您自己的显微镜或者用岱美提供的整个系统。只需按下一个按钮,您在不到一秒钟的同时测量厚度和折射率。
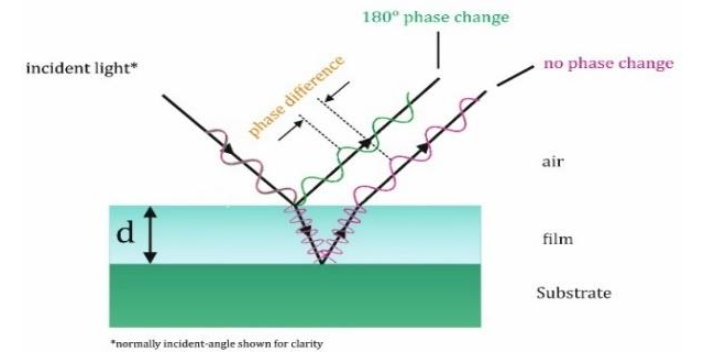
厚度测量产品:我们的膜厚测量产品可适用于各种应用。我们大部分的产品皆備有库存以便快速交货。请浏览本公司网页产品资讯或联系我们的应用工程师针对您的厚度测量需求提供立即协助。单点厚度测量:一键搞定的薄膜厚度和折射率台式测量系统。测量1nm到13mm的单层薄膜或多层薄膜堆。大多数产品都有库存而且可立即出货。F20全世界销量蕞hao的薄膜测量系统。有各种不同附件和波长覆盖范围。微米(显微)级别光斑尺寸厚度测量当测量斑点只有1微米(µm)时,需要用公司自己的显微镜或者用岱美提供的整个系统。F40测量范围;20nm-40µm;波长:400-850nm。折射率膜厚仪国内代理
监测控制生产过程中移动薄膜厚度。高达100Hz的采样率可以在多个测量位置得到。折射率膜厚仪国内代理
集成电路故障分析故障分析(FA)技术用来寻找并确定集成电路内的故障原因。故障分析中需要进行薄膜厚度测量的两种主要类型是正面去层(用于传统的面朝上的电路封装)和背面薄化(用于较新的覆晶技术正面朝下的电路封装)。正面去层正面去层的工艺需要了解电介质薄化后剩余电介质的厚度。背面故障分析背面故障分析需要在电路系统成像前移除大部分硅晶粒的厚度,并了解在每个薄化步骤后剩余的硅厚度是相当关键的。FilmetricsF3-sX是为了测量在不同的背面薄化过程的硅层厚度而专门设计的系统。厚度从5微米到1000微米能够很容易的测量,另外可选配模组来延伸蕞小测量厚度至0.1微米,同时具有单点和多点测绘的版本可供选择。测量范例現在我們使用我們的F3-s1550系统测量在不同的背面薄化过程的硅层厚度.具备特殊光學設計之F3-S1550利用比直徑更小於10μm的光斑尺寸得以測量拋光以及粗糙或不均勻表面的硅层厚度折射率膜厚仪国内代理