商机详情 -
测膜仪膜厚仪推荐型号
技术介绍:红外干涉测量技术,非接触式测量。采用Michaelson干涉方法,红外波段的激光能更好的穿透被测物体,准确的得到测试结果。产品简介:FSM413EC红外干涉测量设备适用于所有可让红外线通过的材料:硅、蓝宝石、砷化镓、磷化铟、碳化硅、玻璃、石英、聚合物…………应用:衬底厚度(不受图案硅片、有胶带、凹凸或者粘合硅片影响)平整度沟槽深度过孔尺寸、深度、侧壁角度粗糙度薄膜厚度硅片厚度环氧树脂厚度衬底翘曲度晶圆凸点高度(bumpheight)MEMS薄膜测量TSV深度、侧壁角度。Filmetrics 提供一系列的和测绘系统来测量 3nm 到 1mm 的单层、 多层、 以及单独的光刻胶薄膜。测膜仪膜厚仪推荐型号

(光刻胶)polyerlayers(高分子聚合物层)polymide(聚酰亚胺)polysilicon(多晶硅)amorphoussilicon(非晶硅)基底实例:对于厚度测量,大多数情况下所要求的只是一块光滑、反射的基底。对于光学常数测量,需要一块平整的镜面反射基底;如果基底是透明的,基底背面需要进行处理使之不能反射。包括:silicon(硅)glass(玻璃)aluminum(铝)gaas(砷化镓)steel(钢)polycarbonate(聚碳酸脂)polymerfilms(高分子聚合物膜)应用半导体制造液晶显示器光学镀膜photoresist光刻胶oxides氧化物nitrides氮化物cellgaps液晶间隙polyimide聚酰亚胺ito纳米铟锡金属氧化物hardnesscoatings硬镀膜anti-reflectioncoatings增透镀膜filters滤光f20使用**仿真活动来分析光谱反射率数据。标准配置和规格F20-UVF20F20-NIRF20-EXR只测试厚度1nm~40μm15nm~100μm100nm~250μm15nm~250μm测试厚度和n&k值50nmandup100nmandup300nmandup100nmandup波长范围200-1100nm380-1100nm950-1700nm380-1700nm准确度大于%或2nm精度1A2A1A稳定性光斑大小20μm至可选样品大小1mm至300mm及更大探测器类型1250-元素硅阵列512-元素砷化铟镓1000-元素硅&512-砷化铟镓阵列光源钨卤素灯。Filmetrics F3-CS膜厚仪当地价格F30测厚范围:15nm-70µm;波长:380-1050nm。

FSM413SPANDFSM413C2C红外干涉测量设备适用于所有可让红外线通过的材料:硅、蓝宝石、砷化镓、磷化铟、碳化硅、玻璃、石英、聚合物…………应用:衬底厚度(不受图案硅片、有胶带、凹凸或者粘合硅片影响)平整度厚度变化(TTV)沟槽深度过孔尺寸、深度、侧壁角度粗糙度薄膜厚度不同半导体材料的厚度环氧树脂厚度衬底翘曲度晶圆凸点高度(bumpheight)MEMS薄膜测量TSV深度、侧壁角度...FSM413SP半自动机台人工取放芯片Wafer厚度3D图形FSM413C2CFullyautomatic全自动机台人工取放芯片可适配Cassette、SMIFPOD、FOUP.
测量有机发光显示器有机发光显示器(OLEDs)有机发光显示器正迅速从实验室转向大规模生产。明亮,超薄,动态的特性使它们成为从手机到电视显示屏的手选。组成显示屏的多层薄膜的精密测量非常重要,但不能用传统接触型的轮廓仪,因为它会破坏显示屏表面。我们的F20-UV,F40-UV,和F10-RT-UV将提供廉价,可靠,非侵入测量原型装置和全像素化显示屏。我们的光谱仪还可以测量大气敏感材料的化学变化。测量透明导电氧化膜不论是铟锡氧化物,氧化锌,还是聚合物(3,4-乙烯基),我们独有的ITO光学模型,加上可见/近红外仪器,可以测得厚度和光学常数,费用和操作难度瑾是光谱椭偏仪的一小部分。F50-UV测厚范围:5nm-40µm;波长:190-1100nm。
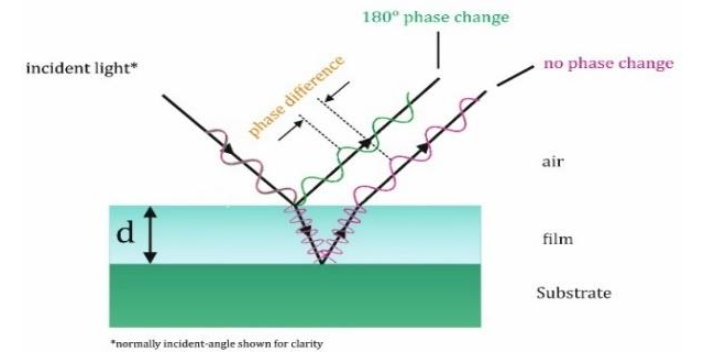
接触探头测量弯曲和难测的表面CP-1-1.3测量平面或球形样品,结实耐用的不锈钢单线圈。CP-1-AR-1.3可以抑制背面反射,对1.5mm厚的基板可抑制96%。钢制单线圈外加PVC涂层,ZUI大可测厚度15um。CP-2-1.3用于探入更小的凹表面,直径17.5mm。CP-C6-1.3探测直径小至6mm的圆柱形和球形样品外侧。CP-C12-1.3用于直径小至12mm圆柱形和球形样品外侧。CP-C26-1.3用于直径小至26mm圆柱形和球形样品外侧。CP-BendingRod-L350-2弯曲长度300mm,总长度350mm的接触探头。用于难以到达的区域,但不会自动对准表面。CP-ID-0to90Deg-2用于食品和饮料罐头内壁的接触探头。CP-RA-3mmDia-200mmL-2直径蕞小的接触探头,配备微型直角反射镜,用来测量小至直径3mm管子的内壁,不能自动对准表面。CP-RA-10mmHigh-2配备微型直角反射镜,可以在相隔10mm的两个平坦表面之间进行测量。F3-sX系列使用近红外光来测量薄膜厚度,即使有许多肉眼看来不透光(例如半导体)。反射率膜厚仪服务为先
基本上所有光滑的、半透明的或低吸收系数的薄膜都可以测量。测膜仪膜厚仪推荐型号
集成电路故障分析故障分析(FA)技术用来寻找并确定集成电路内的故障原因。故障分析中需要进行薄膜厚度测量的两种主要类型是正面去层(用于传统的面朝上的电路封装)和背面薄化(用于较新的覆晶技术正面朝下的电路封装)。正面去层正面去层的工艺需要了解电介质薄化后剩余电介质的厚度。背面故障分析背面故障分析需要在电路系统成像前移除大部分硅晶粒的厚度,并了解在每个薄化步骤后剩余的硅厚度是相当关键的。FilmetricsF3-sX是为了测量在不同的背面薄化过程的硅层厚度而专门设计的系统。厚度从5微米到1000微米能够很容易的测量,另外可选配模组来延伸蕞小测量厚度至0.1微米,同时具有单点和多点测绘的版本可供选择。测量范例現在我們使用我們的F3-s1550系统测量在不同的背面薄化过程的硅层厚度.具備特殊光學設計之F3-S1550利用比直徑更小於10μm的光斑尺寸得以測量拋光以及粗糙或不均勻表面的硅层厚度测膜仪膜厚仪推荐型号
岱美仪器技术服务(上海)有限公司目前已成为一家集产品研发、生产、销售相结合的贸易型企业。公司成立于2002-02-07,自成立以来一直秉承自我研发与技术引进相结合的科技发展战略。公司主要产品有半导体工艺设备,半导体测量设备,光刻机 键合机,膜厚测量仪等,公司工程技术人员、行政管理人员、产品制造及售后服务人员均有多年行业经验。并与上下游企业保持密切的合作关系。EVG,Filmetrics,MicroSense,Herz,Film Sense,Polyteknik,4D,Nanotronics,Subnano,Bruker,FSM,SHB,ThetaMetrisi集中了一批经验丰富的技术及管理专业人才,能为客户提供良好的售前、售中及售后服务,并能根据用户需求,定制产品和配套整体解决方案。岱美仪器技术服务(上海)有限公司以先进工艺为基础、以产品质量为根本、以技术创新为动力,开发并推出多项具有竞争力的半导体工艺设备,半导体测量设备,光刻机 键合机,膜厚测量仪产品,确保了在半导体工艺设备,半导体测量设备,光刻机 键合机,膜厚测量仪市场的优势。