商机详情 -
采用MEMS加工的MEMS微纳米加工哪里有
MEMS制作工艺深硅刻蚀即ICP刻蚀工艺:硅等离子体刻蚀工艺的基本原理干法刻蚀是利用射频电源使反应气体生成反应活性高的离子和电子,对硅片进行物理轰击及化学反应,以选择性的去除我们需要去除的区域。被刻蚀的物质变成挥发性的气体,经抽气系统抽离,然后按照设计图形要求刻蚀出我们需要实现的深度。干法刻蚀可以实现各向异性,垂直方向的刻蚀速率远大于侧向的。其原理如图所示,生成CF基的聚合物以进行侧壁掩护,以实现各向异性刻蚀刻蚀过程一般来说包含物理溅射性刻蚀和化学反应性刻蚀。对于物理溅射性刻蚀就是利用辉光放电,将气体解离成带正电的离子,再利用偏压将离子加速,溅击在被蚀刻物的表面,而将被蚀刻物质原子击出(各向异性)。对于化学反应性刻蚀则是产生化学活性极强的原(分)子团,此原(分)子团扩散至待刻蚀物质的表面,并与待刻蚀物质反应产生挥发性的反应生成物(各向同性),并被真空设备抽离反应腔MEMS传感器行业为国内企业追赶提供了契机。采用MEMS加工的MEMS微纳米加工哪里有
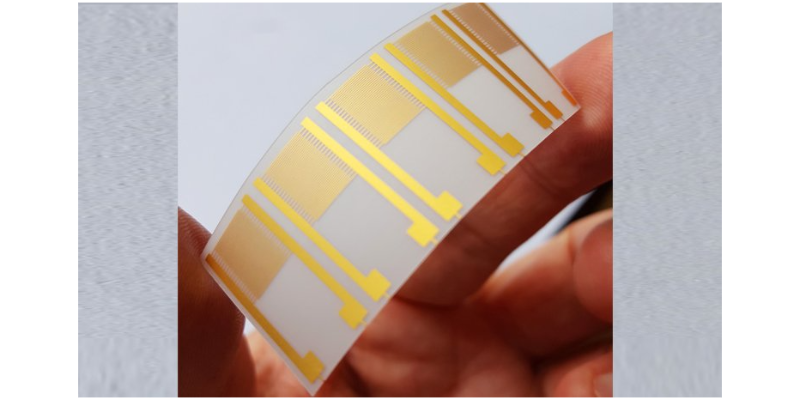
MEMS四种刻蚀工艺的不同需求:
高深宽比:硅蚀刻工艺通常需要处理高深宽比的问题,如应用在回转仪(gyroscopes)及硬盘机的读取头等微机电组件即为此例。另外,此高深宽比的特性也是发展下一代晶圆级的高密度构造连接上的解决方案。考虑到有关高深宽比的主要问题,是等离子进出蚀刻反应区的状况:包括蚀刻剂进入蚀刻接口的困难程度(可借助离子击穿高分子蔽覆层实现),以及反应副产品受制于孔洞中无法脱离。在一般的等离子压力条件下,离子的准直性(loncollimation)运动本身就会将高深宽比限制在约50:1。另外,随着具线宽深度特征离子的大量转移,这些细微变化可能会改变蚀刻过程中的轮廓。一般说来,随着蚀刻深度加深,蚀刻剂成分会减少。导致过多的高分子聚合反应,和蚀刻出渐窄的线宽。针对上述问题,设备制造商已发展出随着蚀刻深度加深,在工艺条件下逐渐加强的硬件及工艺,这样即可补偿蚀刻剂在大量离子迁徙的变化所造成的影响。 西藏MEMS微纳米加工发展现状MEMS四种ICP-RIE刻蚀工艺的不同需求。
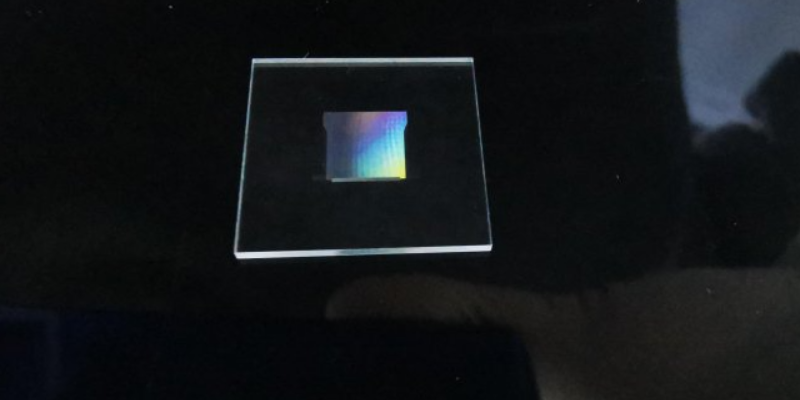
MEMS制作工艺-太赫兹超导混频阵列的MEMS体硅集成天线与封装技术:
太赫兹波是天文探测领域的重要波段,太赫兹波探测对提升人类认知宇宙的能力有重要意义。太赫兹超导混频接收机是具有代表性的高灵敏天文探测设备。天线及混频芯片封装是太赫兹接收前端系统的关键组件。当前,太赫兹超导接收机多采用单独的金属喇叭天线和金属封装,很难进行高集成度阵列扩展。大规模太赫兹阵列接收机发展很大程度受到天线及芯片封装技术的制约。课题拟研究基于MEMS体硅工艺技术的适合大规模太赫兹超导接收阵列应用的0.4THz以上频段高性能集成波纹喇叭天线,及该天线与超导混频芯片一体化封装。通过电磁场理论分析、电磁场数值建模与仿真、低温超导实验验证等手段,
MEMS制作工艺ICP深硅刻蚀:在半导体制程中,单晶硅与多晶硅的刻蚀通常包括湿法刻蚀和干法刻蚀两种方法各有优劣,各有特点。湿法刻蚀即利用特定的溶液与薄膜间所进行的化学反应来去除薄膜未被光刻胶掩膜覆盖的部分,而达到刻蚀的目的。因为湿法刻蚀是利用化学反应来进行薄膜的去除,而化学反应本身不具方向性,因此湿法刻蚀过程为等向性。湿法刻蚀过程可分为三个步骤:1)化学刻蚀液扩散至待刻蚀材料之表面;2)刻蚀液与待刻蚀材料发生化学反应;3)反应后之产物从刻蚀材料之表面扩散至溶液中,并随溶液排出。
湿法刻蚀之所以在微电子制作过程中被采用乃由于其具有低成本、高可靠性、高产能及优越的刻蚀选择比等优点。但相对于干法刻蚀,除了无法定义较细的线宽外,湿法刻蚀仍有以下的缺点:1) 需花费较高成本的反应溶液及去离子水:2) 化学药品处理时人员所遭遇的安全问题:3) 光刻胶掩膜附着性问题;4) 气泡形成及化学腐蚀液无法完全与晶片表面接触所造成的不完全及不均匀的刻蚀 MEMS器件制造工艺更偏定制化。

MEMS制作工艺柔性电子的研究发展:
在近的10年间,康奈尔大学、普林斯顿大学、哈佛大学、西北大学、剑桥大学等国际有名的大学都先后建立了柔性电子技术专门研究机构,对柔性电子的材料、器件与工艺技术进行了大量研究。柔性电子技术同样引起了我国研究人员的高度关注与重视,在柔性电子有机材料制备、有机电子器件设计与应用等方面开展了大量的基础研究工作,并取得了一定进展。中国科学院长春应用化学研究所、中国科学院化学研究所、中国科学技术大学、华南理工大学、清华大学、西北工业大学、西安电子科技大学、天津大学、浙江大学、武汉大学、复旦大学、南京邮电大学、上海大学等单位在有机光电(高)分子材料和器件、发光与显示、太阳能电池、场效应管、场发射、柔性电子表征和制备、平板显示技术、半导体器件和微图案加工等方面进行了颇有成效的研究。近年来,华中科技大学在RFID封装和卷到卷制造、厦门大学在静电纺丝等方面取得了研究进展。
但是在产业化和定制加工方面,基于柔性PI的器件研究开发,深圳的民营科技走在前列。例如基于柔性PI衬底的太赫兹器件、柔性电生理电极、脑机接口柔性电极、电刺激/记录电极、柔性PI超表面器件等等 MEMS技术的主要分类有哪些?采用MEMS加工的MEMS微纳米加工哪里有
MEMS超表面对光电场特性的调控是怎样的?采用MEMS加工的MEMS微纳米加工哪里有
MEMS四种刻蚀工艺的不同需求:
1.体硅刻蚀:一些块体蚀刻些微机电组件制造过程中需要蚀刻挖除较大量的Si基材,如压力传感器即为一例,即通过蚀刻硅衬底背面形成深的孔洞,但未蚀穿正面,在正面形成一层薄膜。还有其他组件需蚀穿晶圆,不是完全蚀透晶背而是直到停在晶背的镀层上。基于Bosch工艺的一项特点,当要维持一个近乎于垂直且平滑的侧壁轮廓时,是很难获得高蚀刻率的。因此通常为达到很高的蚀刻率,一般避免不了伴随产生具有轻微倾斜角度的侧壁轮廓。不过当采用这类块体蚀刻时,工艺中很少需要垂直的侧壁。
2.准确刻蚀:精确蚀刻精确蚀刻工艺是专门为体积较小、垂直度和侧壁轮廓平滑性上升为关键因素的组件而设计的。就微机电组件而言,需要该方法的组件包括微光机电系统及浮雕印模等。一般说来,此类特性要求,蚀刻率的均匀度控制是远比蚀刻率重要得多。由于蚀刻剂在蚀刻反应区附近消耗率高,引发蚀刻剂密度相对降低,而在晶圆边缘蚀刻率会相应地增加,整片晶圆上的均匀度问题应运而生。上述问题可凭借对等离子或离子轰击的分布图予以校正,从而达到均钟刻的目的。 采用MEMS加工的MEMS微纳米加工哪里有