在全球能源消耗持续增长的背景下,以SiC和GaN为主的第三代功率半导体,因其宽禁带特性所带来的耐高压、耐高温与高效率等优异性能,已成为提升能源转换效率的关键材料,普遍应用于新能源汽车、轨道交通、光伏能源、武器装备等高功率场景。然而,这些高性能半导体器件能否在实际工作中稳定、持久地发挥性能,很大程度上取决于封装技术的可靠性。

传统高温焊料(包括高铅和无铅焊料)封装技术是实现芯片与基板连接的主流工艺之一,但其焊接温度通常需超过280℃,不仅不适用于对温度敏感的器件,还会引入较大热应力,影响器件的长期可靠性。为克服这一局限,银烧结技术利用纳米银膏在较低温 度下实现连接,形成的烧结层熔点高,可实现“低温连接、高温服役”。然而,该技术存在两大推广障碍:一是银作为贵金属成本高昂,显著提高器件材料成本;二是烧结过程需施加高压(可达30MPa级别),不仅增加工艺复杂度,还对设备和芯片的机械强度提出更高要求。此外,银在电场作用下易发生电迁移,可能导致器件短路失效。
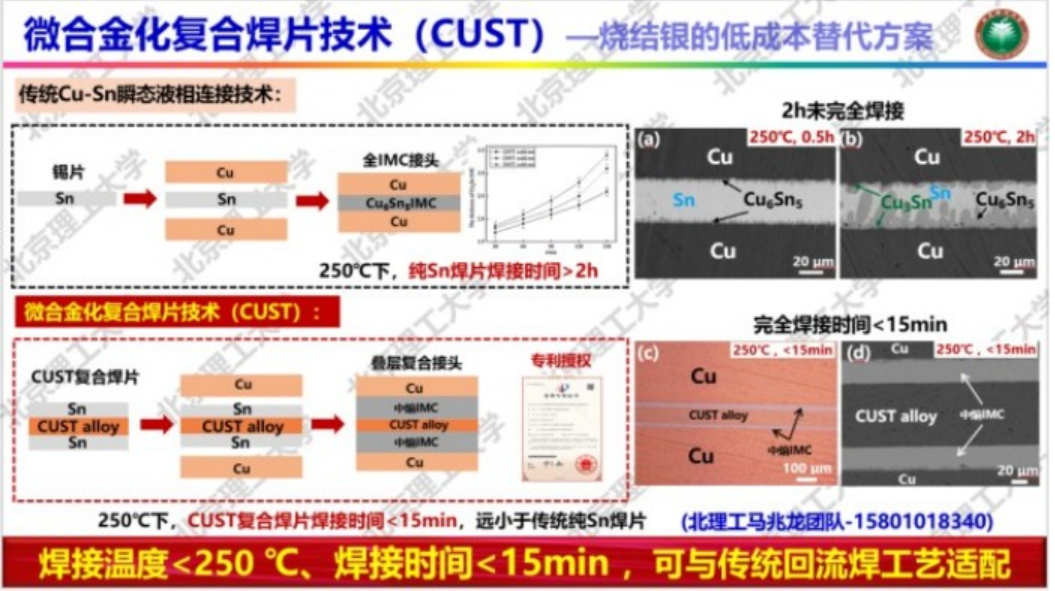
现有封装技术的缺点促使业界寻找更便宜、更高性能的互连解决方案,其中液相键合 (TLB) 技术是重点关注点。该技术允许在相对较低的温度下形成难熔全层金属间化合物(IMC),从而实现“低温结合和高温作”。然而,传统的Cu-Sn TLB技术存在明显的缺点:在250°C下形成全层IMC连接通常需要两个多小时。长时间暴露在高温下会降低设备的可靠性,难以满足现代化生产线的高效要求。
为了解决这些问题,北京理工大学的马兆龙团队开发了一种获得ZL的微掺杂复合焊料(CUST)技术,提供了一种创新的解决方案。CUST采用独特的复合层压结构:纯锡层、CUST微合金层、纯锡层,串联排列。CUST 合金中的各种元素有助于形成具有中等熵的新型金属间化合物 (IMC),从而显着加速其生长动力学。这将形成完整 IMC 连接所需的时间从传统工艺中的两个多小时缩短到不到 15 分钟,效率提高了 8 倍以上。这使得CUST焊片成为传统回流焊工艺的理想选择,提高了生产效率。

作为成立于 2017 年的技术企业,三福电子依托人才团队与持续创新,在电子元器件领域积累了良好信誉。
“质量至上,客户至上” 秉持这一理念。未来,随着新能源、制造等领域的技术升级,三福电子将持续为中国电子产业的高质量发展注入动力。